相關探針和電子顯微鏡™(CPEM)的關聯成像技術簡介
新型掃描探針顯微鏡(SPM)和掃描電子顯微鏡(SEM)關聯成像技術簡介
LiteScope™是一種獨特的掃描探針顯微鏡(SPM)。 它設計用于輕松集成到各種掃描電子顯微鏡(SEM)中。 組合互補的SPM和SEM技術使其能夠利用兩者的優勢。使用LiteScope™及其可更換探針系列,可以輕松進行復雜的樣品分析,包括表面形貌,機械性能,電性能,化學成分,磁性能等的表征。相關探針和電子顯微鏡™(CPEM)結合了SPM和SEM技術。 CPEM可以同時在同一協調系統中同時獲取同一區域的SPM和SEM圖像。 結合SPM和SEM成像方法可以得到分析區域的更廣泛的信息光譜,從而揭示兩種圖像中可能存在的等同性和不一致性。

將樣品連接到壓電掃描儀。 電子束焦點和SPM探針在CPEM圖像采集期間可以對感興趣的區域由壓電掃描器逐點掃描并發出信號,同時對SEM檢測器和SPM探針進行采樣,以便進行測量放在同一個協調系統中。 在SPM尖端和該范圍內的聚焦電子束之間存在恒定的尖端/點偏移數百納米。 如果減去這樣的尖端/點偏移,則SEM和SPM圖像具有完美匹配和優異的相關性- 可以獲取CPEM圖像。

CPEM技術的優點
1. CPEM提供多維相關成像 - 來自掃描電子顯微鏡的圖像被擴展為3D。
2. 使用CPEM,可以快速準確地區分SEM圖像中的地形和材料對比度。
3. CPEM以適當的方式將兩個或多個SEM信號與測量的地形相關聯,例如SE,BSE,EBIC等。
4. CPEM可以在相同的條件下同時測量AFM和SEM試樣條件,相同的測量速度等
5. 組合的AFM和SEM掃描系統可實現精確的圖像相關,消除漂移和其他不準確性。

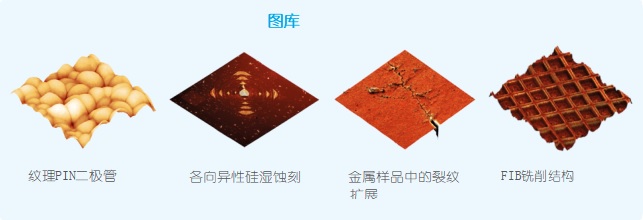
Copyright(C) 1998-2025 生物器材網 電話:021-64166852;13621656896 E-mail:info@bio-equip.com





